Any layer HDI es la abreviación de «placa de circuito impreso de interconexión de alta densidad en cualquier capa» (Any-layer High Density Interconnect) y constituye una de las formas más avanzadas de la tecnología HDI PCB, representando la arquitectura de interconexión más avanzada en los productos electrónicos de gama alta actuales. Any layer HDI se refiere a una placa HDI PCB multicapa en la que todas las capas utilizan interconexiones mediante microvías (Microvia) creadas con láser.
Desde el punto de vista terminológico, «Any-layer» significa «cualquier capa», mientras que «HDI» es la abreviatura de «High Density Interconnect» (interconexión de alta densidad); la combinación de ambos términos define con precisión el núcleo de la tecnología: lograr la interconexión directa entre dos capas cualesquiera de la placa de circuito impreso, rompiendo así las limitaciones de interconexión entre capas propias de las PCB tradicionales y las HDI convencionales.
En esencia, el Any layer HDI consiste en construir, mediante la innovación tecnológica, un sistema de interconexión de circuitos «sin restricciones de capas, de alta integración y de transmisión eficiente», que proporciona a los dispositivos electrónicos de gama alta una optimización máxima del espacio y un rendimiento óptimo en la transmisión de señales.
Desde el punto de vista de la evolución tecnológica, Any layer HDI es una forma de actualización avanzada de la tecnología HDI. El HDI tradicional adopta una arquitectura de «placa central + laminado exterior», en la que las rutas de interconexión están limitadas por la combinación fija de la capa de la placa central y la capa exterior, por lo que solo puede lograr una interconexión limitada entre «la capa exterior y la placa central interna» o «entre placas centrales internas», lo que supone una restricción jerárquica evidente.
Mientras que Any layer HDI abandona por completo este modelo fijo, mediante un proceso de laminado que construye una estructura de circuitos de «superposición capa por capa y conexión arbitraria», de modo que, ya sea entre capas superficiales, entre una capa superficial y cualquier capa interna, o entre capas internas, se pueden construir canales de interconexión directamente, sin necesidad de depender de la placa central como intermediaria.
Esta característica de interconexión «sin restricciones jerárquicas» libera el diseño de los circuitos de las limitaciones de la estructura física, logrando la «minimización» de las rutas de interconexión y la «optimización» del diseño de los circuitos.
Desde el punto de vista de su aplicación, Any layer HDI no es una tecnología de PCB genérica, sino una solución especializada creada para resolver los retos de «alta integración, tamaño reducido y transmisión de alta velocidad» de los dispositivos electrónicos de gama alta. Su núcleo está orientado a escenarios que exigen lo máximo en cuanto a aprovechamiento del espacio en la PCB, eficiencia en la transmisión de señales y fiabilidad, como los smartphones insignia, los dispositivos wearables inteligentes de gama alta, los dispositivos de RA/RV y los instrumentos médicos de precisión.
La aparición de esta tecnología ha superado las limitaciones que la tecnología PCB tradicional imponía a la actualización de los dispositivos electrónicos, haciendo posible el diseño de productos «más pequeños, con más funciones y más rápidos».
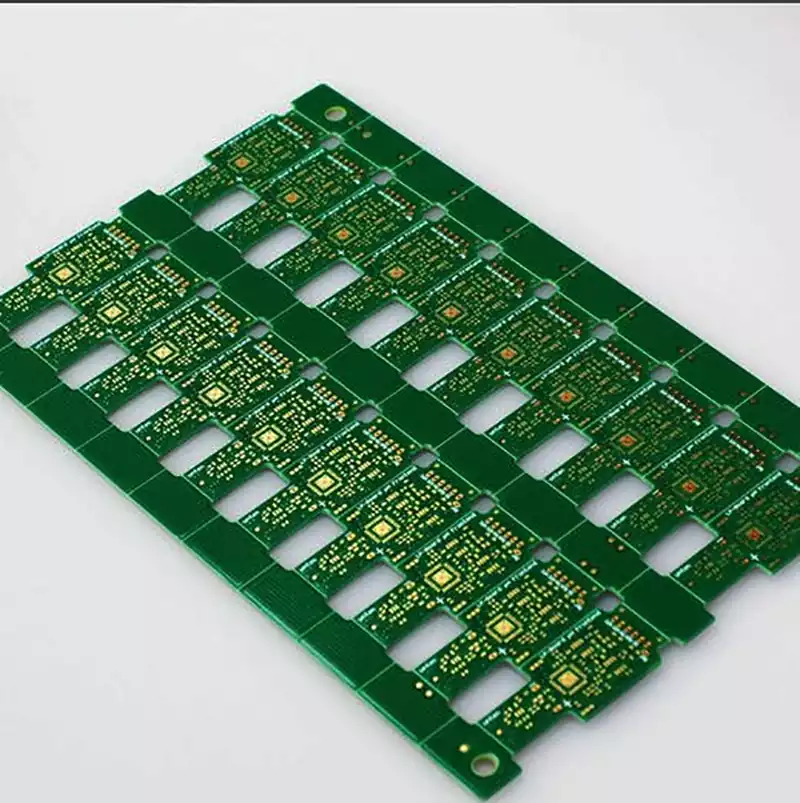
La característica de «interconexión en cualquier capa» de Any layer HDI no se consigue de la nada, sino que se basa en el apoyo coordinado de dos procesos fundamentales: la tecnología de microagujeros ciegos y enterrados por láser y el proceso de fabricación por laminación:
1.Tecnología de microagujeros ciegos y enterrados por láser
La miniaturización de los canales de interconexión es un requisito previo para lograr una interconexión de alta densidad, y la tecnología de microagujeros ciegos y enterrados por láser es precisamente el soporte tecnológico clave que permite la implementación de Any layer HDI. Los PCB tradicionales dependen principalmente del taladrado mecánico para formar los agujeros de interconexión; debido a las limitaciones de la precisión de los equipos y los métodos de procesamiento, el diámetro de los agujeros suele ser superior a 100 μm, y predominan los agujeros pasantes que atraviesan toda la placa.
Este tipo de agujeros pasantes no solo ocupan una gran cantidad de espacio dentro de la placa, sino que también interfieren notablemente en la continuidad de las pistas y la integridad del diseño. Aunque el HDI convencional ha incorporado el proceso de perforación por láser, el diámetro de los orificios suele mantenerse en el rango de 60-80 μm, mientras que el número y la ubicación de los orificios ciegos y enterrados están limitados por el marco estructural de «placa base + capas adicionales», lo que restringe la libertad de interconexión.
Por su parte, el Any layer HDI, gracias a una tecnología de perforación láser de mayor precisión, reduce aún más el diámetro de los orificios ciegos y enterrados hasta 30–50 μm; algunos procesos avanzados pueden incluso alcanzar diámetros ultrapequeños de unos 20 μm, una escala equivalente a solo una cuarta parte del diámetro de un cabello humano.
Y lo que es más importante, la perforación láser permite controlar con precisión la profundidad y la ubicación de los orificios, lo que permite formar de manera flexible, según las necesidades del diseño, orificios ciegos que conectan únicamente la capa superficial con una capa interna específica, u orificios enterrados que interconectan solo las capas internas, sin dañar las líneas de las demás capas.
Este método de interconexión miniaturizada altamente controlable permite aumentar el número de orificios de interconexión que se pueden disponer por unidad de superficie a más del triple que en las estructuras tradicionales, lo que proporciona una base sólida para el cableado de ultra alta densidad.
Además, el taladrado por láser es un proceso de mecanizado sin contacto, lo que evita el riesgo de concentración de tensiones y microfisuras que el taladrado mecánico genera en el sustrato, lo que contribuye a mejorar la estabilidad estructural general y la fiabilidad a largo plazo de la placa de circuito impreso.
2.Proceso de fabricación por laminación
Si la tecnología de microagujeros ciegos y enterrados por láser resuelve el problema de «reducir el tamaño» de los canales de interconexión, el proceso de fabricación por laminación resuelve de raíz el problema de las «limitaciones de capas» que ha existido durante mucho tiempo en las interconexiones multicapa.
Las PCB tradicionales y las HDI comunes suelen adoptar un enfoque de fabricación que consiste en «fabricar primero la placa central y luego laminar las capas externas a ambos lados», por lo que la configuración del número de capas y la distribución de las líneas de la placa central quedan fijadas desde el principio, y las interconexiones posteriores solo pueden desarrollarse dentro de la estructura establecida, lo que presenta una característica evidente de «la estructura va primero y las interconexiones están limitadas».
Por su parte, el Any layer HDI, mediante la introducción del proceso de laminación «construcción y interconexión capa por capa», ha logrado un cambio fundamental desde la lógica de diseño hasta la ruta de fabricación, es decir, primero se planifican las relaciones de interconexión y luego se construye la estructura jerárquica según las necesidades.
Desde el punto de vista del proceso, el método de laminación puede entenderse como un ciclo altamente estandarizado: se toma una capa de circuitos como base inicial y se recubre su superficie con un medio aislante; a continuación, se perforan microagujeros en las posiciones designadas mediante láser; luego, se utiliza un proceso de galvanoplastia para rellenar los agujeros con metal, lo que permite la conexión eléctrica entre la capa actual y la nueva capa de circuitos; una vez completada la interconexión, se procede a la formación de una nueva capa de circuitos.
Los pasos mencionados anteriormente («creación de circuitos — recubrimiento aislante — perforación con láser — interconexión metalizada») se repiten continuamente, de modo que la placa de circuito se va apilando capa a capa y tomando forma gradualmente.
En este modelo de fabricación, cada capa de circuitos cuenta con una gran libertad de diseño independiente, y se puede lograr una interconexión directa entre dos capas cualesquiera mediante procesos de perforación y metalización controlados con precisión, lo que elimina por completo las restricciones de las rutas de interconexión entre capas impuestas por la arquitectura tradicional de las placas base.
Al mismo tiempo, dado que el método de laminación reduce o incluso sustituye los procesos de prensado integral múltiple, la tensión entre capas se reduce significativamente, lo que disminuye de manera efectiva los riesgos estructurales como la delaminación o las grietas, mejorando así aún más el rendimiento global de Any layer HDI en aplicaciones de alta densidad y alta fiabilidad.
Diferencias fundamentales con respecto al HDI tradicional
| Dimensiones comparativas | HDI tradicional | Any layer HDI |
| Interconexión entre capas | Solo capas externas adyacentes | Cualquier capa con cualquier otra |
| Estructura de orificios pasantes | Combinación de PTH y microorificios | Estructura totalmente de microorificios |
| Libertad de trazado | Limitada por las capas centrales | Interconexión similar a la de los circuitos integrados |
| Complejidad del proceso | Media | Muy alta |
| Nivel de coste | Bajo | Muy alto |
Principales ventajas del Any layer HDI
Máxima libertad de trazado
El diseño ya no está limitado por la ubicación de los agujeros pasantes ni de las capas centrales, lo que facilita la planificación de señales complejas de alta velocidad.
Reducción significativa del tamaño y el grosor de la placa
Ideal para productos ultradelgados y de altísima integración.
Excelentes prestaciones eléctricas
Agujeros microescénicos y bajos parámetros parásitos, lo que favorece la transmisión de señales de alta velocidad y alta frecuencia.
Compatibilidad con formas de encapsulado avanzadas
Satisface las necesidades de interconexión de SoC, AP y módulos de radiofrecuencia con un elevado número de E/S.
Direcciones de mejora futuras del Any layer HDI
A medida que las funciones de los dispositivos electrónicos de gama alta siguen mejorando, la tecnología Any layer HDI también evoluciona hacia una mayor precisión, eficiencia y respeto por el medio ambiente, y en el futuro se observarán tres tendencias de mejora fundamentales.
En primer lugar, el avance hacia la «microminiaturización». Actualmente, el diámetro de los orificios del Any layer HDI ya alcanza los 20 μm, con un ancho y un espaciado de líneas de 15/15 μm. En el futuro, se superarán los límites hasta alcanzar un diámetro de 15 μm y un ancho y espaciado de líneas de 10/10 μm, lo que mejorará aún más la densidad de las líneas y el aprovechamiento del espacio, adaptándose a las necesidades de los chips de mayor integración.
Este avance requiere una tecnología de perforación láser más precisa y procesos de galvanoplastia más avanzados. Actualmente, la industria ya ha comenzado a investigar la tecnología de perforación con láser de ultravioleta profundo para lograr un mecanizado preciso de diámetros de orificio aún más pequeños.
En segundo lugar, la «multicapa» y la «integración multifuncional». Para satisfacer las necesidades de interconexión de un mayor número de componentes funcionales, el número de capas de los Any layer HDI pasará de las 8-12 actuales a 16-20, al tiempo que se integrarán gradualmente componentes pasivos como resistencias y condensadores enterrados, logrando una integración unificada de «PCB + componentes pasivos» y reduciendo aún más el volumen de los dispositivos. Por ejemplo, al enterrar resistencias y condensadores directamente en la capa aislante de la PCB, se puede reducir el número de componentes superficiales y mejorar la compacidad del diseño de las líneas.
En tercer lugar, la mejora en materia de «sostenibilidad medioambiental». Impulsada por los objetivos globales de «doble carbono», las exigencias medioambientales del sector de la fabricación electrónica son cada vez más estrictas. El HDI de cualquier capa adoptará progresivamente procesos y materiales ecológicos, como el galvanizado sin cianuro, las tintas de máscara de bajo contenido en COV y los materiales aislantes biodegradables, con el fin de reducir las emisiones contaminantes durante el proceso de producción.
Al mismo tiempo, el sector reforzará el reciclaje de los residuos de la producción de PCB, mejorará la tasa de reciclaje de residuos sólidos como placas de desecho y residuos de cobre, e impulsará el desarrollo sostenible y ecológico de Any layer HDI.

Any layer HDI es el resultado del desarrollo de la tecnología HDI hacia la integración extrema y la interconexión libre. Su esencia consiste en utilizar una estructura totalmente microporosa y de capas superpuestas para romper las limitaciones jerárquicas de los PCB multicapa tradicionales, proporcionando a los productos electrónicos de alta gama una capacidad de interconexión cercana al nivel de los semiconductores.