Any layer HDI est l’abréviation de « Any-layer High Density Interconnect » (circuit imprimé à interconnexion haute densité sur n’importe quelle couche). Il s’agit de l’une des formes les plus avancées de la technologie des circuits imprimés HDI et représente l’architecture d’interconnexion la plus moderne actuellement utilisée dans les produits électroniques haut de gamme. Any layer HDI désigne un circuit imprimé HDI multicouche dont toutes les couches sont interconnectées par des microvias (micropores créés au laser).
Du point de vue terminologique, « Any layer » signifie « n’importe quelle couche », tandis que « HDI » est l’abréviation de « High Density Interconnect » (interconnexion haute densité). La combinaison de ces deux termes met précisément en évidence le cœur de la technologie : réaliser une interconnexion directe entre deux couches quelconques du circuit imprimé, dépassant ainsi les limites de l’interconnexion intercouche des circuits imprimés traditionnels et des circuits HDI classiques.
L’Any layer HDI consiste essentiellement, grâce à des innovations technologiques, à construire un système d’interconnexion de circuits « sans contrainte de couches, à haute intégration et à transmission efficace », offrant ainsi aux équipements électroniques haut de gamme une utilisation optimale de l’espace et des performances de transmission de signaux exceptionnelles.
Du point de vue de l’évolution technologique, l’Any layer HDI constitue une version améliorée de la technologie HDI. Le HDI traditionnel adopte une architecture de type « carte mère + couches externes laminées », où les chemins d’interconnexion sont limités par la combinaison fixe entre la couche de la carte mère et les couches externes, ne permettant qu’une interconnexion limitée entre « la couche externe et la couche interne de la carte mère » ou « entre les couches internes de la carte mère », ce qui entraîne des contraintes hiérarchiques évidentes.
L’Any layer HDI abandonne quant à lui complètement ce modèle fixe. Grâce à un procédé de stratification, il construit une structure de circuits « superposée couche par couche et permettant une conduction arbitraire ».
Qu’il s’agisse de la surface avec la surface, de la surface avec n’importe quelle couche interne, ou encore d’une couche interne avec une autre, il est possible de construire directement des voies d’interconnexion sans passer par le circuit central. Cette caractéristique d’interconnexion « sans contrainte hiérarchique » libère la disposition des circuits des contraintes de la structure physique, permettant ainsi de « raccourcir au maximum » les chemins d’interconnexion et d’« optimiser » la disposition des circuits.
Du point de vue de son application, l’Any layer HDI n’est pas une technologie PCB générique, mais une solution spécialisée conçue pour résoudre les problèmes de « haute intégration, faible encombrement et transmission à haut débit » des équipements électroniques haut de gamme. Elle s’adresse principalement aux applications exigeant le summum en matière d’utilisation de l’espace sur le circuits imprimés, d’efficacité de transmission des signaux et de fiabilité, telles que les smartphones haut de gamme, les appareils portables intelligents haut de gamme, les équipements de réalité augmentée (RA) et de réalité virtuelle (RV), ainsi que les instruments médicaux de précision.
L’émergence de cette technologie a brisé les limites imposées par les technologies traditionnelles de circuits imprimés à la mise à niveau des appareils électroniques, rendant possible la conception de produits « plus compacts, plus fonctionnels et plus rapides ».
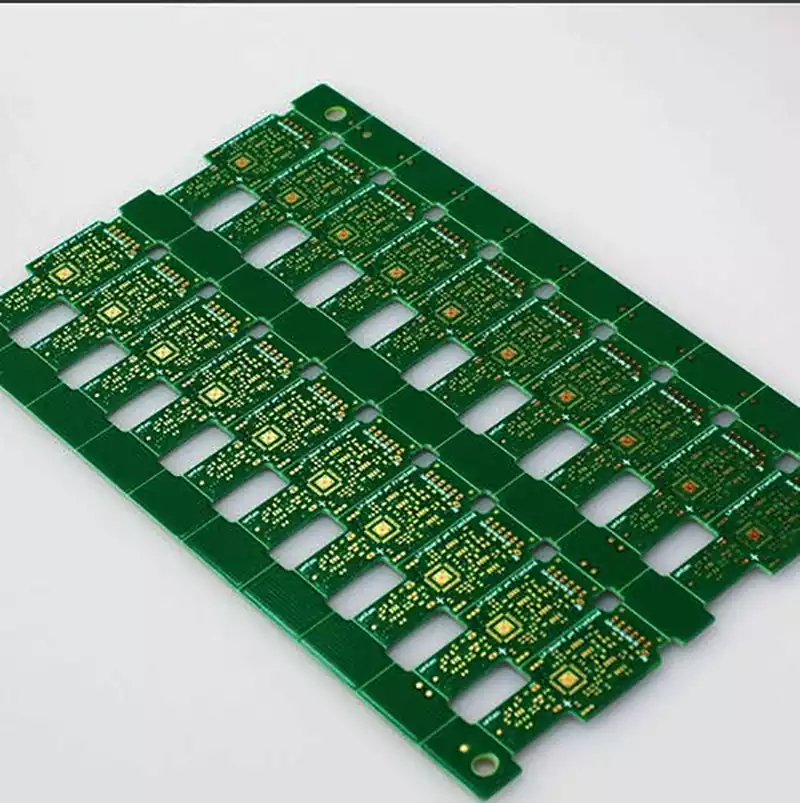
La fonctionnalité « interconnexion sur n’importe quelle couche » de l’HDI Any-layer ne se concrétise pas par magie, mais repose sur la synergie de deux procédés clés : la technologie de micro-perçage aveugle au laser et le procédé de fabrication par stratification :
1.Technologie de micro-perçage aveugle au laser
La miniaturisation des voies d’interconnexion est une condition préalable à la réalisation d’une interconnexion haute densité, et la technologie de micro-perçage aveugle au laser constitue précisément le soutien technique essentiel à la mise en œuvre de l’HDI Any layer. Les circuits imprimés traditionnels (PCB) s’appuient principalement sur le perçage mécanique pour former les trous d’interconnexion.
En raison des limites de précision des équipements et des méthodes d’usinage, le diamètre des trous est généralement supérieur à 100 μm, et il s’agit principalement de trous traversants qui traversent toute l’épaisseur de la carte. Ces trous traversants occupent non seulement beaucoup d’espace à l’intérieur de la carte, mais ils perturbent également de manière significative la continuité des pistes et l’intégrité de l’agencement.
Bien que le HDI classique ait introduit le perçage au laser, le diamètre des trous reste généralement compris entre 60 et 80 μm. De plus, le nombre et l’emplacement des trous borgnes et enfouis sont limités par la structure « carte mère + couches supplémentaires », ce qui restreint la liberté d’interconnexion.
Le HDI « Any-layer », quant à lui, utilise une technologie de perçage laser de plus haute précision pour réduire encore davantage le diamètre des trous borgnes et enfouis à 30–50 μm. Certains procédés avancés permettent même d’atteindre des diamètres ultra-petits d’environ 20 μm, soit une taille équivalente à seulement un quart du diamètre d’un cheveu humain. Plus important encore, le perçage au laser permet un contrôle précis de la profondeur et de l’emplacement des trous.
Il est ainsi possible de former de manière flexible, en fonction des besoins de conception, des trous borgnes reliant uniquement la couche supérieure à une couche interne spécifique, ou des trous enfouis interconnectant uniquement les couches internes, sans endommager les circuits des autres couches. Ce mode d’interconnexion miniaturisé hautement contrôlable permet de multiplier par plus de trois le nombre de trous d’interconnexion pouvant être disposés par unité de surface par rapport aux structures traditionnelles, offrant ainsi une base solide pour un câblage à très haute densité.
De plus, le perçage au laser est un procédé d’usinage sans contact qui évite les risques de concentration de contraintes et de microfissures sur le substrat liés au perçage mécanique, ce qui contribue à améliorer la stabilité structurelle globale et la fiabilité à long terme des circuits imprimés.
2.Procédé de fabrication par stratification
Si la technologie des micro-vias aveugles et enterrés par laser permet de « réduire la taille » des voies d’interconnexion, le procédé de fabrication par stratification résout quant à lui de manière radicale le problème de « limitation des couches » qui persiste depuis longtemps dans les interconnexions multicouches. Les circuits imprimés traditionnels et les circuits HDI classiques suivent généralement un principe de fabrication consistant à « fabriquer d’abord le circuit central, puis à laminer les couches externes de part et d’autre ».
La configuration du nombre de couches et la répartition des circuits du circuit central sont ainsi fixées dès le début, et les interconnexions ultérieures ne peuvent se développer que dans le cadre de cette structure prédéfinie, ce qui se traduit par une caractéristique évidente de « priorité à la structure, interconnexions limitées ». Le Any layer HDI, quant à lui, introduit le procédé de fabrication par stratification, qui consiste à « construire et interconnecter couche par couche », réalisant ainsi une transformation fondamentale, de la logique de conception au processus de fabrication : il s’agit d’abord de planifier les relations d’interconnexion, puis de construire la structure hiérarchique à la demande.
Du point de vue du processus de fabrication, la méthode de stratification peut être comprise comme un cycle hautement standardisé : une couche de circuits unique sert de base initiale, recouverte d’un isolant à sa surface ; ensuite, des micro-perforations sont réalisées à des emplacements précis par perçage laser ; puis, un procédé de galvanoplastie permet de remplir les trous de métal, établissant ainsi une connexion électrique entre la couche actuelle et la nouvelle couche de circuits ; une fois l’interconnexion terminée, la formation d’une nouvelle couche de circuits peut commencer.
Les étapes susmentionnées (« fabrication des circuits – revêtement isolant – perçage au laser – interconnexion par métallisation ») se répètent en boucle, permettant ainsi à la carte de s’épaissir couche par couche et de prendre progressivement forme.
Dans ce mode de fabrication,chaque couche de circuits bénéficie d’une grande liberté de conception indépendante,et deux couches quelconques peuvent être directement interconnectées grâce à des processus de perçage et de métallisation précis et contrôlés, ce qui élimine complètement les contraintes imposées par l’architecture traditionnelle des cartes mères sur les chemins d’interconnexion entre les couches.
Par ailleurs, comme le procédé de stratification atténue, voire remplace, les multiples étapes de pressage global, les contraintes entre les couches sont considérablement réduites, ce qui diminue efficacement les risques structurels tels que la délamination et la fissuration, améliorant ainsi les performances globales de l’Any layer HDI dans les applications à haute densité et haute fiabilité.
Principales différences par rapport au HDI traditionnel
| Critère de comparaison | HDI traditionnel | Any layer HDI |
| Interconnexion entre les couches | Uniquement entre les couches externes adjacentes | De n’importe quelle couche à n’importe quelle autre couche |
| Structure des trous de passage | Mélange de PTH et de micro-trous | Structure entièrement composée de micro-trous |
| Liberté de routage | Limitée par les couches centrales | Proche du niveau d’interconnexion des circuits intégrés |
| Complexité du procédé | Moyenne | Très élevée |
| Coût | Élevé | Très élevé |
Principaux avantages de l’Any layer HDI
Liberté de routage maximale
La conception n’est plus limitée par l’emplacement des trous traversants et des couches centrales, ce qui facilite la planification des signaux complexes à haute vitesse.
Réduction significative de la taille et de l’épaisseur des cartes
Idéal pour les produits ultra-minces et à très haute densité d’intégration.
Excellentes performances électriques
Les trous micropores sont courts et les paramètres parasites faibles, ce qui favorise la transmission de signaux à haute vitesse et haute fréquence.
Prise en charge des formes d’encapsulation avancées
Répond aux besoins d’interconnexion des SoC, AP et modules RF à nombre élevé d’E/S.
Orientations futures de l’évolution de l’Any layer HDI
À mesure que les fonctionnalités des appareils électroniques haut de gamme continuent de s’améliorer, la technologie Any layer HDI évolue vers plus de précision, d’efficacité et de respect de l’environnement. À l’avenir, trois grandes tendances d’évolution se dessineront.
Premièrement, une percée dans la « miniaturisation extrême ». Actuellement, le diamètre des trous dans l’Any layer HDI peut déjà atteindre 20 μm, avec une largeur et un espacement des lignes de 15/15 μm. À l’avenir, on passera à un diamètre de trou de 15 μm et à une largeur et un espacement des lignes de 10/10 μm, ce qui améliorera encore la densité des circuits et l’utilisation de l’espace, afin de répondre aux besoins des puces à plus haute intégration.
Cette avancée repose sur des techniques de perçage laser plus précises et des procédés de galvanoplastie plus avancés. L’industrie a déjà entamé la R&D sur la technologie de perçage laser à ultraviolets profonds afin de permettre un usinage précis de trous de diamètre encore plus petit.
Deuxièmement, la « multicouche » et l’« intégration multifonctionnelle ». Afin de répondre aux besoins d’interconnexion d’un plus grand nombre de composants fonctionnels, le nombre de couches des Any layer HDI passera des 8 à 12 couches actuelles à 16 à 20 couches. Parallèlement, des composants passifs tels que des résistances et des condensateurs enfouis seront progressivement intégrés, permettant ainsi une intégration unifiée « PCB + composants passifs » et une réduction supplémentaire de l’encombrement des équipements. Par exemple, l’intégration directe de résistances et de condensateurs dans la couche isolante du PCB permet de réduire le nombre de composants en surface et d’améliorer la compacité du tracé des circuits.

Troisièmement, la transition vers une « écologisation ». Sous l’impulsion des objectifs mondiaux « double carbone », les exigences environnementales de l’industrie de la fabrication électronique deviennent de plus en plus strictes. Les Any layer HDI adopteront progressivement des procédés et des matériaux respectueux de l’environnement, tels que la galvanoplastie sans cyanure, les encres de masquage à faible teneur en COV et les matériaux isolants biodégradables, afin de réduire les émissions de polluants au cours du processus de production. Parallèlement, l’industrie renforcera la valorisation des déchets issus de la production de circuits imprimés, améliorera le taux de recyclage des déchets solides tels que les circuits imprimés usagés et les résidus de cuivre, et favorisera le développement durable et écologique de l’Any layer HDI.
Les Any layer HDI sont le résultat de l’évolution de la technologie HDI vers une intégration extrême et une interconnexion libre. Leur essence réside dans une structure entièrement micro-perforée et à couches multiples, qui brise les limites hiérarchiques des circuits imprimés multicouches traditionnels et offre aux produits électroniques haut de gamme une capacité d’interconnexion proche de celle des semi-conducteurs.